A novel test structure with two active areas for eNVM reliability studies
Résumé
This paper presents a test structure with a poly floating gate shared on two actives areas. Programming and erase can be split toward these two regions with a specific arsenic implantation. The aim is to study the tunnel oxide degradation and the injection efficiency of embedded charge storage memory cells.
Fichier principal
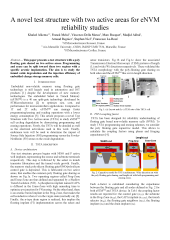 A_novel_test_structure_with_two_active_areas_for_eNVM_reliability_study.pdf (1)
Télécharger le fichier
A_novel_test_structure_with_two_active_areas_for_eNVM_reliability_study.pdf (1)
Télécharger le fichier
| Origine | Fichiers produits par l'(les) auteur(s) |
|---|
